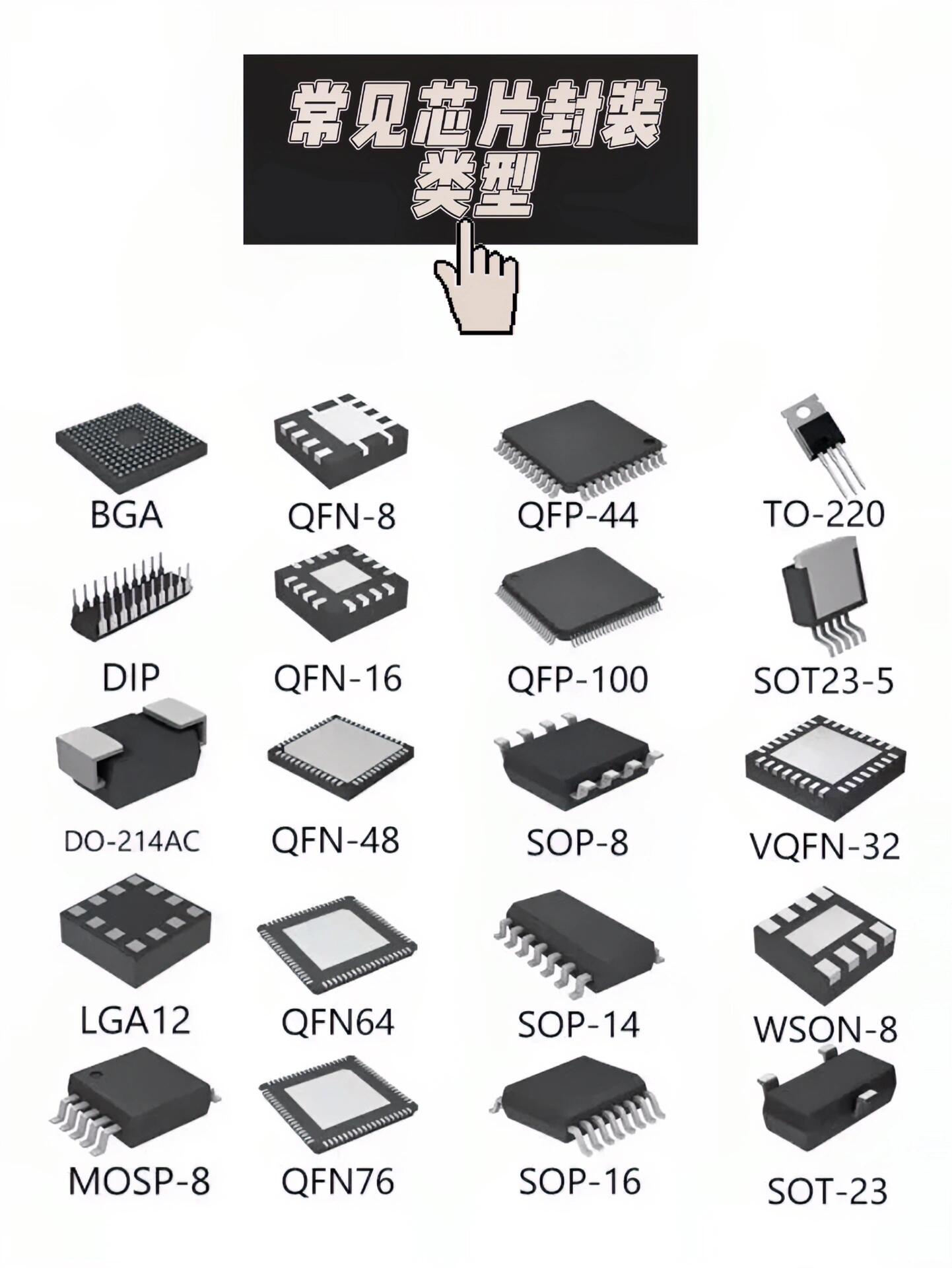
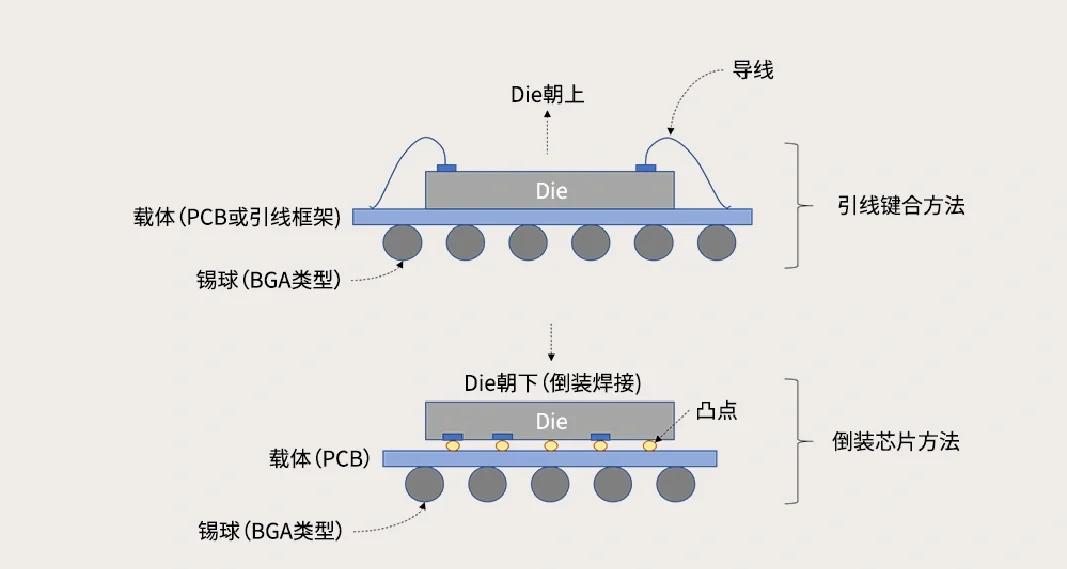
| 封装类型 | 技术特点 | 最小线宽 | 适用产品 |
|---|---|---|---|
| 2.5D/3D封装 | 硅通孔(TSV)、微凸块、异构集成 | 10μm | AI芯片、HPC、高端处理器 |
| 扇出型封装 | 芯片先上(Die First)、重布线层 | 15μm | 移动设备、物联网芯片 |
| 系统级封装(SiP) | 多芯片集成、被动元件集成 | 25μm | 射频模块、电源管理 |
| 传统封装 | QFN、BGA、CSP、SOP等 | 35μm | 通用IC、模拟芯片 |
将晶圆减薄至所需厚度,通常100-300μm
使用精密划片机将晶圆切割成单个芯片
将芯片粘贴到封装基板或引线框架上
使用金线或铜线连接芯片和封装引脚
用环氧树脂保护芯片,形成最终封装体
将整条封装体切割成单个器件
品牌:Advantest, Teradyne
通道数:512-1024通道
测试频率:最高1GHz
品牌:Tokyo Electron
精度:±5μm
支持尺寸:6-12英寸晶圆
品牌:Advantest
UPH:最高20,000颗/小时
支持封装:QFN, BGA, CSP等

24小时内响应客户需求,提供专业解决方案
封装良率>99.5%,测试覆盖率>98%
完善的保密制度,保护客户知识产权
实时生产进度跟踪,定期质量报告